Ball Semiconductor媄弍夛媍曬崘
丂侾俋俋俉擭俈寧侾係擔乣侾俇擔偵奐嵜偝傟偨Ball Semiconductor幮偺媄弍夛媍
偵嶲壛偟偨帪偺撪梕傪曬崘偟傑偡
杮夛媍偵嶲壛偟偨栚揑偼丄
侾丏 敿摫懱検嶻岺応寶愝偺寶愝旓偺掅尭傪壜擻偲偡傞媄弍側偺偐
俀丏 屭媞偺嵶偐偄梫媮偵懳墳偱偒傞敿摫懱傪抁婜娫K梫側悢検嶌傞媄弍側偺偐
傪抦傝偨偐偭偨偐傜偱偡丅 敪昞撪梕偐傜偼丄壔妛僾儔儞僩偺敪憐偱敿摫懱慺巕傪嶌傞偺偼
桳岠側曽朄偱偼側偄偐偲姶偠傑偟偨丅
杮媄弍偺幚梡壔偼丄旝嵶壔偺梫媮偑彮側偄僶僀億乕儔乮僟僀僆乕僪g儔儞僕僗僞乯慺巕偱憗偔
偵幚尰偱偒傞偺偱偼側偄偐偲巚偄傑偡丅杮夛媍乮 幚嵺偼丄尋廋堳敪昞偺傛偆側姶偠 乯偺朻摢
偵憂嬈幰偼丄尷傜傟偨儕僜乕僗乮帒嬥l瀶詠j偱奐敪蕩Y壔傪峴偆偨傔丄婎慴媄弍偺奐敪
埲崀偱帺暘偨偪偑偱偒傞偺偼丄旝嵶側俴俽俬偱偼側偔懢梲揹抮摍偺敿摫懱偱偁傞偲岅偭偰偄傑偟偨丅
丂
壓婰偺婰嵹偱丄恾斣偑嬻棑偵側偭偰偄傑偡丅
*************************
Ball Semiconductor幮
夛幮奣梫
幮丂柤丗儃乕儖丒僙儈僐儞僟儞僋僞乕丒僀儞僐乕億儗僀僥僢僪
戙昞幰丗夛挿寭幮挿丂丂愇愳丂柧
杮丂幮丗 暷崙僥僉僒僗廈傾儗儞巗乮僟儔僗嬤峹乯
愝丂棫丗1996擭10寧
憂嬈幰偱偁傞 愇愳丂柧巵偑峫埬偟偨丄俽倝媴傪巊偭偨敿摫懱慺巕偺奐敪傪峴偭偰偄
傞丅尰嵼偺庡側弌帒幰偼擔宯婇嬈偑愯傔偰偄傞丅奐敪奐巒偐傜侾擭敿偱丄憰抲偺僾儘
僩僞僀僾偺奐敪傪廔椆偟丄俹乗俶愙崌僟僀僆乕僪丒俵俷俽僟僀僆乕僪傪幚尰偡傞強傑
偱奐敪偑恑傫偱偄傞丅俋俉擭俈寧偺媄弍夛媍偼丄崱屻偺弌帒幰偺曞廤傗媄弍偺儔僀僙
儞僗愭傊偺愰揱傪栚揑偲偟偰奐嵜偝傟傑偟偨丅
媄弍夛媍偵嶲壛偡傞枠偼丄幚尰惈偑掅偄偺偱偼側偄偐偲峫偊偰偄傑偟偨偑丄幚嵺偵帋
嶌昳偺姰惉僨乕僞傪尒傞偲幚尰壜擻偱偼側偄偐偲峫偊傞傛偆偵側傝傑偟偨丅媄弍夛媍
偺嶲壛幰偺懡偔偼弌帒婇嬈傗嫤巀戝妛偺擔杮恖偱偟偨乮 俇侽亾偖傜偄 乯丅
敿摫懱儊乕僇乕偺嶲壛幰偼丄傎偲傫偳偄側偐偭偨偺偱偼側偄偐偲巚偄傑偡丅幚嵺
偺憰抲奐敪傕擔宯婇嬈偑嶲壛偟偰偄傑偡丅嶰堜僴僀僥僢僋丒僨傿僗僐丒怴擔揝側偳偺
柤慜偑丄揥帵僷僱儖傗僾儗僙儞僥乕僔儑儞帒椏偵婰嵹偝傟偰偄傑偟偨丅
仏仏仏仏仏仏仏仏仏仏仏仏仏仏仏仏
奣梫
儃乗儖僙儈僐儞僟僋僞幮偼尦俿俬暃幮挿偺愇愳巵偲拠栰巵偑侾俋俋俇擭偵愝棫偟偨丄
俽倝媴昞柺偵敿摫懱傪宍惉偡傞媄弍傪奐敪偡傞夛幮偱偁傞丅摨幮偼侾俋俋俈擭偐傜奐
敪傪巒傔丄俁擭娫乮仏侾乯偺媄弍丒憰抲偺奐敪屻丄検嶻岺応傪寶愝偟丄敿摫懱偺検嶻
奐巒傪栚巜偟偰偄傞丅崱夞偺媄弍夛媍偺栚揑偼丄俽倝媴敿摫懱偺媄弍傪岞奐偟丄嫤巀
偡傞婇嬈傪曞傞偙偲 媦傃 摨媄弍偺晛媦傪栚揑偲偟偰偄傞丅
尰嵼偼丄
丂乮侾乯懡寢徎倫倧倢倷亅俽倝傪梟偐偟丄俽倝媴傪宍惉偡傞媄弍偺奐敪
丂乮俀乯巁壔丒奼嶶丒儂僩儕僜丒嬥懏枌宍惉丒幚憰偺奺梫慺媄弍偺奐敪
丂乮俁乯忋婰傪幚尰偡傞旕愙怗張棟憰抲偺奐敪
丂乮係乯俽倝媴傊偺夞楬愝寁偺俠俙俢偺奐敪
傪恑傔偰偄傞丅崱夞偺敪昞偺拞偱偼丄奺梫慺媄弍傪摑崌偟丄俵俷俽僟僀僆乕僪丒
俹俶愙崌僟僀僆乕僪傪惢嶌偟偰應掕偟偨揹婥摿惈傪敪昞偟偰偄偨丅
尰嵼偺儃乕儖僙儈僐儞僟僋僞乕幮偺嫤椡婇嬈 媦傃 戝妛偼丄傎偲傫偳擔杮偱偟偨丅
椺丗
倫倧倢倷乗俽倝偐傜俽倝媴傊偺宍惉 乗乗乗(怣墇敿摫懱)丠
俽倝媴偺尋杹 乗乗 俢倝倱們倧
俽倝媴張棟偺攝娗媄弍 乗乗 嶰堜僴僀僥僢僋
儂僩儕僜梡嵽椏娭學 乗乗搶嫗墳壔
俽倝媴傊偺僶儞僾宍惉 媄弍 乗乗 怴擔揝
業岝憰抲撪俽倝媴埵抲寛傔媄弍 乗乗搶嫗擾岺戝
摨幮偑栚巜偟偰偄傞俽倝媴敿摫懱偺摿挜偼丄
丂乮侾乯侾倣倣兂偺俽倝媴忋偵敿摫懱傪宍惉偟丄儀傾幚憰傪峴偆
丂乮俀乯楢懕偟偨僠儏乕僽撪偱俽倝媴傪壛岺偡傞偙偲偵傛傞僋儕乕儞儖乕儉儗僗壔
丂乮俁乯憰抲偺彫宆壔乮掅壙奿壔乯摍偵傛傞丄俴倧倵 俠倧倱倲敿摫懱岺応偺幚尰
丂乮係乯忋婰偵傛傞丄尰忬斾侾丒侾侽偺僠僢僾僐僗僩偺幚尰
丂乮俆乯俠俿亖俆擔 乮倫倧倢倷乗俽倝 乣 俽倝媴敿摫懱偺姰惉傑偱乯
偱偁傞丅
奺梫慺媄弍
侾丏旕愙怗張棟偺婎杮[棳検寁偺拞偺晜巕偺尨棟]
巇慻傒偼丄僔儞僾儖偱偡丅愇塸僈儔僗偺僠儏乕僽偺壓偐傜僄傾乕乮枖偼 僈僗乯傪
悂偒忋偘丄廳椡丒悂偒忋偘椡偑椡偑掁傝崌偭偨忬懺偱俽倝媴傪曐帩丂枖偼丂棊壓偝偣
傞丅

仏仏僠儏乕僽暻柺偲媴偺娫偵棳傟傞僄傾乕偵傛傝暻柺偲偺愙怗傪杊巭偱偒傞仏仏
俀丏俽倝媴偺宍惉
俽倝媴偺宍惉偼丄恾仏偺僼儘乕偱峴偆丅悢倣倣偺棻傪俬俠俹偱丄 俀侽侽侽
乣俉侽侽侽亱俲偵壛擬偟丄塼揌忬偺俽倝媴傪宍惉偡乮偙偺帪偵棳偡僈僗偵丄俛倰俀傗
俹俷俠俴俁摍傪擖傟傞偙偲偱晄弮暔揧壛傕壜擻乯丅偦偺屻偵尋杹偟丄俽倝媴偵偡傞丅
俁丏 巁壔丒奼嶶丒俠倁俢乮僷僢僔儀乕僔儑儞丒儊僞儖宍惉
係丏 偺旕愙怗張棟媄弍傪墳梡偟偰偄傞丅
俁丏侾 巁壔
旕愙怗偱 偐偮 媴懱偱偁傞偨傔僂僃乕僴偺傛偆偵崅壏偱乽偦傞乿偲偄偆栤戣偑側偄偺
偱丄捠忢乮侾侾侽侽亷埵乯傛傝崅偄壏搙乮侾俁侽侽亷埵乯偺張棟偑壜擻偱偁傞丅
摨幮偺幚尡寢壥偱偼丄乽寢徎柺乮侾侽侽乯丄乮侾侾侾乯偵傛傞奼嶶懍搙偺嵎偼丄俽倝
媴偱偼崅壏張棟偺偨傔尒傜傟側偄丅傑偨巁壔偼丄俢倕倎倢亅俧倰倧倴倕懃偲崌抳偟偰
偄偨丅乿偲偄偆曬崘偱偁偭偨丅
俁丏俀 奼嶶
巁壔偺帪偺僈僗傪曄偊偰峴偆
乮侾乯 俶宆奼嶶 乗乗乗 俹俷俠倢俁亄俷俀
侾俆暘偺俢倕倫倧偲侾俆暘偺俢倰倝倴倕 俬値偱丄俁丏俈兪倣偺奼嶶憌傪宍惉
乮俀乯 俹宆奼嶶乗乗乗俛俛倰俁亄俷俀
仏仏寢徎曽埵偵傛傞奼嶶懍搙偺堘偄偼丄張棟壏搙偑僂僃乕僴偵斾傋崅壏偺偨傔丄嵎偑柍偄偲岅偭偰偄傑偟偨丅仏仏
俁丏俁 俠倁俢
乮侾乯 俽倝俁俶係
俽倝俁俶係偼丄俉俆侽亷掱搙偱宍惉偡傞
Gas偼丄俽倝俫係偲俶俫俁丠
惉挿懍搙偼丄俆侽侽侌乛俈俆sec乮俇侌乛sec乯掱搙
乮俀乯 俿俤俷俽
惉挿懍搙偼丄侾俆侽侽侌乛侾俉侽sec乮俉侌乛sec乯
乮俁乯 儊僞儖宍惉
俙俴攝慄憌偺宍惉偵偼丄俿俢俵俙俿僈僗傪巊梡偟丄宍惉偡傞丅偙偺僈僗偱宍惉偝傟傞
俙俴枌偼崅枾搙偺俙俴偺傾僀儔儞僪峔憿偲側偭偰偄傞丅
係丏 僄僢僠儞僌
攝娗撪偵塼懱傪棳偟偰丄俽倝媴傪僄僢僠儞僌偡傞丅僄僢僠屻偺俽倝媴偼丄婓庍屻俶俀
偱攝娗撪偱姡憞偟丄師偺岺掱傊憲傞丅
俢倰倷僄僢僠儞僌偵偮偄偰偼丄尰嵼専摙拞偱偁傞丅
俆丏 儂僩儕僜媄弍
揾晍丒儀乕僋丒尰憸傕攝娗撪偱峴偭偰偄傞丅儗僕僗僩偼丄搶嫗墳壔偺俷俥俹俼亅
俉侽侽偺夵椙宆乮侾侽們倫乯傪巊梡偟偰偄傞丅尰嵼偺儗僕僗僩揾晍偼恾仏偺傛偆偵儗
僕僗僩枌偵俽倝媴傪棊壓偟丄曪傒崬傫偱偄傞丅
僷僞乕僯儞僌屻偺俽俤俵幨恀偱偼侾丏俆兪m掱搙偺儔僀儞傑偱夝憸偟偰偄偨丅尰嵼偼
枌岤偽傜偮偒偺偨傔偐丠丄俽倝媴忋偺攝慄偑偲偙傠偳偙傠徚幐偟偰偄偨丅
業岝偼恾仏偺傛偆側業岝憰抲傪巊梡偟偰丄堦妵業岝傪峴偭偰偄傞丅
彨棃偺儂僩儕僜媄弍偲偟偰偼丄媴柺宍忬偵棫懱揑偵媕憸偝偣傞丠偙偲偑壜擻側儂儘僌
儔僼傿乕媄弍傗俤俛捈昤媄弍傪棙梡偡傞丅
俽倝媴偺旕愙怗偺埵抲寛傔媄弍偼丄搶嫗擾岺戝偱奐敪偝傟偨挻壒攇儌乕僞乕乮Ultra
sonic Spherical Motor乯傪巊梡偟偰偄傞丅媴偺夞揮丒掆巭傪價僨僆偱尒偣偰偄偨丅幚
嵺偵媴偺堦晹傪僇僢僩偟偨暔乮俽倝媴乯傪巊偭偰丄夞揮丒掆巭丒媡夞揮乮倃丒倄丒倅
幉曽岦慡偰乯偑偱偒傞偙偲傪幚徹偟偰偄偨丅
媴偺堏摦傕旕愙怗偱曐帩偟丄堏摦傪峴偭偰偄偨乮恾仏乯
業岝岺掱偱偼媴偑攝娗奜偵弌傞偨傔丄業岝憰抲偺晹暘偼僋儕乕儞儖乕儉偑昁梫偲側
傞丅
俇丏 揹嬌宍惉媄弍
俽倝媴敿摫懱摨巑傗僾儕儞僩婎斅偲偺揹婥揑愙懕偵偼丄俙倳儃乕儖傪巊梡偟偰偄傞丅
幚嵺偵俹俠俛偲俽倝媴敿摫懱丄俽倝媴摨巑傪愙懕偟偨僒儞僾儖傪尠旝嬀偱尒傟傞傛偆
偵偟偰偄偨丅
俙倳儃乕儖偺宍惉丒愙懕媄弍偼丄怴擔揝偑嫤椡偟偰偄偨丅
俈丏 僋儔僗僞媄弍
捈宎侾倣倣兂偺昞柺愊偱偼丄尰忬偺倁俴俽俬夞楬慡偰傪俽倝媴忋偵昤夋偡傞偙偲偼晄
壜擻偱偁傞丅偦偺偨傔丄俽倝媴枅偵暿乆偺婡擻傪帩偨偣丄偦傟傜傪廤愊偟倁俴俽俬傪
嶌傝忋偘傞埬傪採彞偟偰偄偨丅
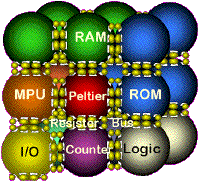
俉丏俿俠俙俢
廬棃偵側偄攝慄峔憿乮俁師尦乯偺偨傔丄愱梡偺俠俙俢傕奐敪偟偰偄偨丅幚嵺偵敪昞偺
惾忋 媦傃 揥帵幒偱僜僼僩傪憱傜偣偨忬嫷傪僨儌偟偰偄傑偟偨丅
俋丏 帋嶌昳偺揹婥摿惈
乮侾乯 俵俷俽僟僀僆乕僪
丂丂丂丂丂乮侾俁侽侽亷偱 俽倝俷俀枌宍惉亄俙倢亅俠倁俢亄俙俴儂僩乯
敪昞偟偨僨乕僞偱偼丄惍棳摿惈偼弌偰偄傑偣傫偱偟偨丅
乮俀乯 俹俶愙崌僟僀僆乕僪
僽儗乕僋僟僂儞揹埑傑偱偼應掕偟偰偄側偄偑丄惍棳摿惈偺弌偨僨乕僞偲側偭偰偄傑偟偨丅
侾侽丏崱屻偺寁夋偵偮偄偰
摨幮偼俀侽侽侽擭偵偼丄俽倝媴敿摫懱偺検嶻偵擖傞偙偲傪栚巜偟偰偄傞丅偟偐偟丄偦
偺帪揰偱壗傪嶌傞偐偵偮偄偰偼丄柧妋偵側偭偰偄側偄丅俬俠奐敪幰偺僕儍僢僋丒僉儖
價乕攷巑懠敿摫懱偺愭払幰傪彽偒傾僪僶僀僗傪庴偗丄曽恓傪専摙偟偰偄傞忬嫷偱偟偨丅